一維(1D)垂直氮化物是非常有吸引力的發光二極管(LED)的應用,因為它們有助于克服傳統GaN平面結構的缺點。然而,作為典型的一維GaN結構,GaN多量子阱(MQW)納米線(NW)LED的內部量子效率(IQE)仍然很低,無法取代標準的平面LED。在這里,我們報告了一種通過引入石墨烯量子點(GQD)的核殼InGaN/GaN NW LED的光放大現象。當尺寸為5、10和20 nm的GQDs單獨位于多量子阱中或同時位于多量子阱和p-GaN表面時,光致發光(PL)和電致發光(EL)強度顯著增強,但當尺寸為30和40 nm的GQDs時,PL和EL增加較少,這與尺寸相關的光輸出功率(OOP)和光提取效率(LEE)一致。GQD和MQW之間的載流子轉移受尺寸相關的帶隙變化和取決于是否在LED上施加正向偏置的帶廓的強烈影響。這解釋了為什么PL和EL光譜顯示GQD的不同尺寸依賴性。通過在LED中加入GQD,OOP的變化由IQE而不是LEE控制。本研究的發現突出了通過在多量子阱和p-GaN表面引入GQD的簡單方法顯著增強GaN多量子阱NW LED的光發射,并且在廣泛的光電子器件中具有很好的應用前景。
.png)
圖1. (a) 在4英寸圖案化藍寶石襯底上制造的典型p–n InGaN/GaN多量子阱核殼NW示意圖。將膠體GQDs溶液噴涂到多量子阱和/或p-GaN表面。(b) 由p-GaN、n-GaN和MQW組成的典型NW的頂面示意圖。(c和d)分別為無/有GQD的典型NWs的b部分藍色標記區域的低倍HRTEM圖像。(e和f)NW頂面附近區域的高倍HRTEM圖像,如d部分中的綠色和紅色標記,清楚地顯示了p-GaN上以及MQW和p-GaN之間存在GQD。
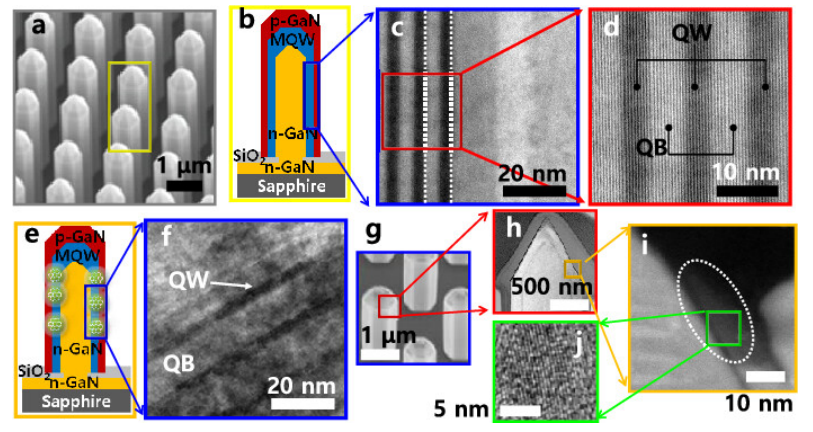
圖2. (a) 直徑為 ∼900 nm、長度為 ∼2 μm 的 NW 的傾斜視圖 SEM 圖像,表明整個區域的均勻性很高。(b) 無 GQD 的典型 p-n InGaN/GaN MQW 核殼西北示意圖。(c) 低倍率 HRTEM 圖像,顯示無 GQD 的三周期 MQW 活性層的均勻形成。在界面 InGaN/GaN MQWs 邊界附近未觀察到有缺陷的結構。(d) 無 GQD 的 NW 中 MQW 的高倍率 HRTEM 圖像。(e) 具有 GQD 的典型 p-n InGaN/GaN MQW 核殼 NW 的示意圖。(f) HRTEM 圖像顯示 QB 層在包含 GQD 后厚度幾乎翻了一番。(g-j) SEM 和 HRTEM 圖像清楚地顯示了 GQD 在 NW 上部區域的 MQW 和 p-GaN 之間的井位置。
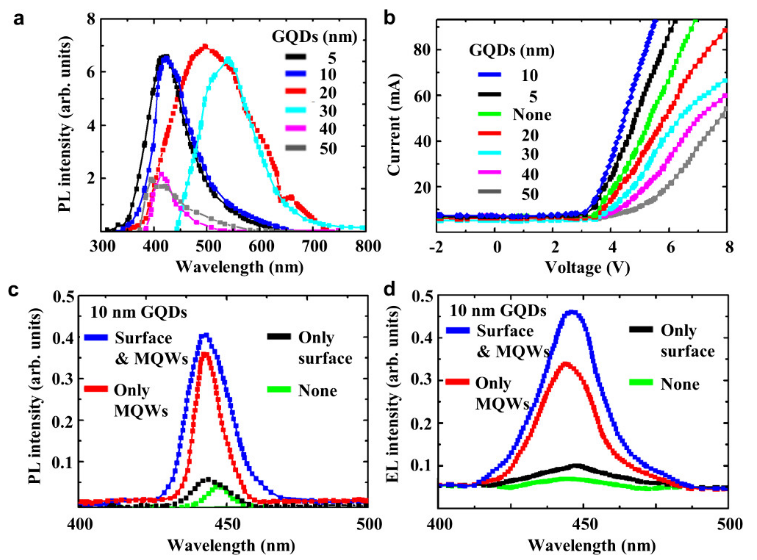
圖3. (a) 不同尺寸的GQD去離子水中 的 PL 譜圖。(b) 各種尺寸的帶 GQD 的 LED 的暗電流-電壓 (I-V) 特性。(c) MQW 和/或 p-GaN 表面無/有 ∼10 nm GQD 的 LED 的 PL 光譜。(d) 在 50 mA 的注入電流下,MQW 和/或 p-GaN 表面沒有/有 ∼10 nm GQD 的 LED 的 EL 光譜。
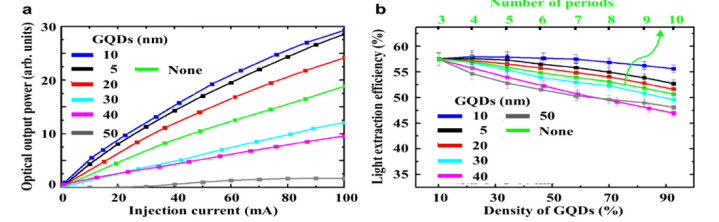
圖4. (a) 各種尺寸的 MQW 和 p-GaN 表面有 GQD 的 LED 的注入電流依賴性 OOP,以及沒有 GQD 的 LED。(b) LED 的 LEE 隨各種尺寸的 GQD 密度的函數。在這里,僅對于沒有 GQD 的 LED,LEE 在上軸上繪制為 MQW 周期(或對)的函數,從 3 到 10。
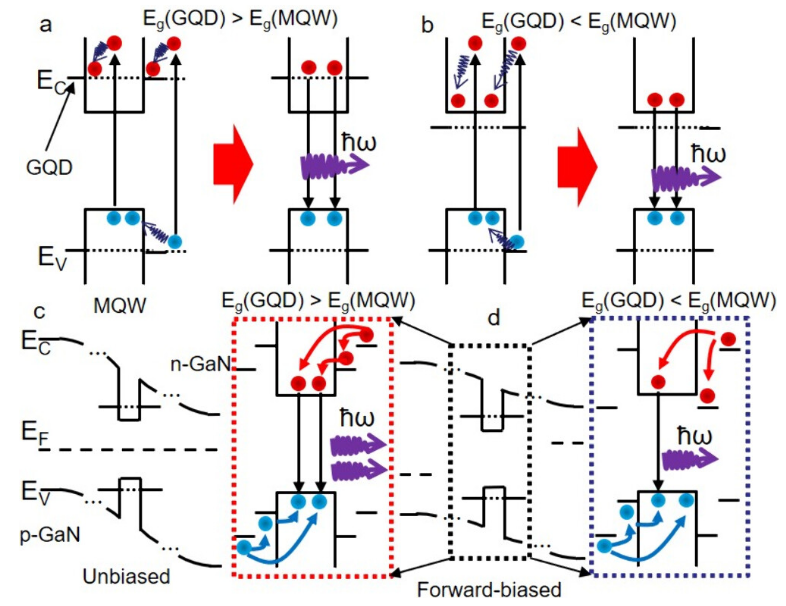
圖5. 當 (a) GQD 的能隙大于 MQW 的能隙,以及 (b) 相反的情況下,描述了具有GQDs. PL過程的典型 p-n InGaN/GaN MQW 核殼 NW 的帶圖。(C 和 D)分別是無偏和正向偏頻帶圖。當 GQD 的能量間隙大于 MQW 的能量間隙時,也會描述 EL 過程,反之亦然。
相關研究成果由慶熙大學Suk-Ho Choi課題組2025年發表在ACS Applied Materials & Interfaces (鏈接:https://doi.org/10.1021/acsami.4c20553)上。原文:Strong Enhancement of Light Emission in Core–Shell InGaN/GaN Multi-Quantum-Well Nanowire Light-Emitting Diodes by Incorporating Graphene Quantum Dots
轉自《石墨烯研究》公眾號

.png)